Спектральные эллипсометры серии MUL-S

ООО "Эмтион"
Спектральный эллипсометр. Образцы до 300 мм, спектр 193 - 2500 нм
Описание Спектральные эллипсометры серии MUL-S
Серия MUL-S – это высокоточный, быстродействующий спектроскопический эллипсометр широкого спектра для научных исследований и промышленных условий, охватывающий диапазон длин волн от УФ до БИК.
В спектроскопическом эллипсометре серии MUL-S используется широкополосный суперахроматический компенсатор, режим выборки для одновременных измерений с помощью двух вращающихся компенсаторов, высокочувствительный блок регистрации спектра и программное обеспечение для анализа спектроскопического эллипсометра для измерения образцов нанопленок, объемных материалов и анизотропных материалов. Серия MUL-S может измерять такие виды образцов материалов, как:
- Параметры структуры слоев (например, толщина пленки) и физические параметры (например, показатель преломления n, коэффициент экстинкции k или диэлектрические функции ε1 и ε2) однослойных и/или многослойных нанопленок.
- Физические параметры объемного материала (например, показатель преломления n, коэффициент экстинкции k или диэлектрические функции ε1 и ε2).
- Измерение спектрального пропускания T и спектрального отражения R образцов с зеркальным покрытием.
- Свойства анизотропных образцов, включая фазовое замедление волновой пластинки, азимут быстрой оси и т.д.
- Извлечение информации о профиле, такой как геометрически критические размеры (CD) и информация об оптических особенностях специальных образцов.
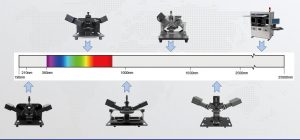
Кроме того, прибор оснащен мощным программным обеспечением для спектроскопической эллипсометрии и анализа ETEGS, которое разработано в виде мастера для упрощения работы и подходит как для новичков, так и для экспертов; программное обеспечение имеет собственную базу данных материалов и предустановленные рецепты для упрощения процесса моделирования
Особенности спектрального эллипсометра серии MUL-S
- Метод вращающейся выборки с двойным компенсатором: все 16 элементов матрицы Мюллера образца могут быть измерены;
- Скорость измерения полного спектра: типовое время измерения занимает менее 10 секунд;
- Чувствительность обнаружения на атомном уровне: измерение на атомарном уровне;
- Видеовыравнивание образца: точное выравнивание образца и простое наблюдение для уменьшения человеческих ошибок;
- Регулировка нескольких углов падения: структура с несколькими углами падения разработана для повышения гибкости прибора, особенно для ультратонких или сложных образцов;
- Измерение отражательной способности/пропускания: измерения спектрального отражения и пропускания образца;
- Управление прибором одним щелчком мыши: при выполнении рутинных операций сложные процессы измерения, моделирования, подгонки и анализа можно завершить одним нажатием кнопки мыши, а обширная библиотека моделей и материалов также облегчает расширенные операционные потребности пользователя.
Применения
- Структуры полупроводниковых пленочных структур: диэлектрическая пленка, металлическая пленка, полимер, фоторезист, кремний, пленка PZT, лазерный диод GaN и AlGaN, прозрачные пленки и т. д.;
- Полупроводниковые периодические наноструктуры: нанорешетки, память с изменением фазового состояния и др.;
- Исследования новых материалов и новых физических явлений: оптическая анизотропия материалов, электрооптический эффект, упруго-оптический эффект, акустооптический эффект, магнитооптический эффект, оптический эффект вращения, эффект Керра, эффект Фарадея и др.;
- Плоские дисплеи: TFT, OLED, плазменные панели, гибкие дисплеи и т. д.;
- Фотогальваника: фотогальванические материалы (такие как Si3N4, Sb2Se3, Sb2S3, CdS и т. д.), отражательная способность, измерение коэффициента экстинкции, измерение толщины пленки и шероховатости поверхности и т. д.;
- функциональные покрытия: просветляющие, самоочищающиеся, электрохромные, зеркально-оптические покрытия, а также полимерные, масляные, Al2O3 поверхностные покрытия и обработка;
- Биологическая и химическая инженерия: органическая пленка, самособирающиеся монослои, белковый субмолекулярный слой, пленочная адсорбция, модифицированные поверхности и т. д.;
- Анализ сыпучих материалов: характеристика показателя преломления n и коэффициента экстинкции k твердых тел (металлов, полупроводников, сред и т. д.) или жидкостей (чистых веществ или примесей), исследования и разработки новых стекол, контроль качества и т. д.

Серия MUL-S имеет приборы для различного спектрального диапазона измерений от 193 нм до 2500 нм. Системы оснащаются как ручными, так и автоматическими гониометрами. Существуют серии как для R&D целей, так и для промышленного применения (в том числе, анализа полупроводниковых пластин, поликремниевых образцов и др). Для специализированных задач доступны приборы с большим спектральным диапазоном.
Опции
- Вакуумный насос для крепления легких и тонких образцов.
- Адсорбационный предметный столик (для работы с гибкими образцами).
- Моторизованный предметный столик.
- Высокотемпературный и низкотемпературный нагревательный стол.
- Предметный столик трех размеров на выбор: 100 мм x 100 мм, 200 мм x 200 мм, 300 мм x 300 мм.
- Micro spot (для измерения малых областей, диаметр пятна (spot) – 180 мкм).
- Детектор неровности поверхности.
- Авторасположение образца в 2D на предметном столике
Спектральные эллипсометр серии MUL-S представлены в трех версиях:
- MUL-S(A) – модель с ручным гониометром.
- MUL-S(M) – модель с автоматическим гониометром.
- MUL-S(F) – модель с фиксированным углом падения
|
Технические характеристики спектрального эллипсометра серии MUL-S |
||
|
Спектральный диапазон |
От 193 нм до 2500 нм (в зависимости от конфигурации системы) |
|
|
Угол падения |
A: автоматический гониометр 30°-90°, компьютерное управление и автоматическая регулировка, точность лучше 0,02° М: ручной гониометр 40° -90°, шаг 5°, точность лучше 0,02° Ф: фиксированный угол Предустановленный угол составляет 70° (или 65°, 75°), регулируемый до 90°, точность выше 0,02° |
|
|
Повторяемость измерений |
При стандартной толщине пленки SiO2 100 нм: Повторяемость – 0,01 нм Точность показателя преломления оптической среды: 0,0005 |
|
|
Время однократного измерения |
Измерение значений Y / D в полном спектре Типичное время измерения 5-10 секунд |
|
|
Схема измерения |
Поляризатор – Компенсатор – Образец – Компенсатор – Анализатор |
|
|
Источник света |
Высокостабильный источник света широкого спектра |
|
|
Пятно измерения |
Регулируемое вручную 1-4 мм |
|
|
Спектральное разрешение |
УФ диапазон (-1000нм): ~1.6 нм, 2048 линий суммарно ИК диапазон (1000-1700 нм): ~3,2 нм, 512 линий суммарно ИК диапазон (1000-2500 нм): ~7,5 нм, 512 линий суммарно |
|
|
Предметный столик |
8 дюймов (200 мм)/ 12 дюймов (300 мм) Регулировка высоты 10 мм Регулировка 2D в диапазоне ± 4 ° |
|
|
Управляющее ПО |
Доступные языки: Английский/Китайский |
|
|
Разделение уровней доступа |
Есть (администратор/оператор) |
|
|
Измерение в ПО |
Автоматическая установка азимута оптического пути Ручной/автоматический режим измерений Отображение спектра в стандартных единицах энергии или длин волн Мониторинг отклика образца, отслеживание изменений Y / D в режиме реального времени |
|
|
Комплектация |
Основной блок спектрального эллипсометра Компьютер Блок управления (блок электроники) Программное обеспечение измерения и анализа Оксид кремния (SiO2) на кристаллическом кремнии диаметром 4″, номинальная толщина пленки 100 нм |
|
Может быть полезно:
Спектральные эллипсометры серии PV

Спектральный эллипсометр серии PV – это высокопроизводительный специализированный […]
Запрос цены ПодробнееЛазерные эллипсометры серии LS

Лазерный эллипсометр серии LS – это многоугловой лазерный эллипсометр, […]
Запрос цены ПодробнееСпектральные эллипсометры серии MUL

Спектральный эллипсометр серии MUL – это высокоточный и […]
Запрос цены Подробнее

