Изображение растрового электронного микроскопа (РЭМ) на экране монитора формируется в процессе сканирования поверхности образца электронным зондом по двум координатам. Масштаб изображения при постоянном размере экрана находится в обратной зависимости от дистанции перемещения зонда в процессе сканирования.
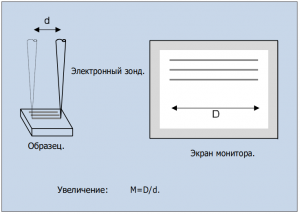 |
| Методика расчета увеличения РЭМ |
Например, при размере экрана монитора 10 см и ширине области перемещения электронного зонда 1 мм достигается 100-кратное увеличение, а при дистанции сканирования 10 мкм – 10000 крат. А в современных микроскопах регулируемое значение кратности может доходить до 1 000 000, как, например, в линейке СЭМ KyKy. Традиционно увеличение рассчитывается для стандартного экрана 12 см (по горизонтали) и 10 см (по вертикали), размер которого варьируется в определенных пределах в зависимости от производителя оборудования РЭМ. С увеличением размеров дисплея по сравнению со стандартным монитором возрастает изображение РЭМ. В этом случае увеличение и размеры объекта рассчитываются по шкале, отображаемой на экране в качестве справки.
Глубина резкости в системе РЭМ
Поскольку изображение РЭМ выглядит, как в процессе наблюдения невооруженным глазом, визуально все особенности объекта представляются интуитивно понятными. Однако время от времени возникает труднообъяснимый контраст отдельных элементов, управление которым требует глубокого понимания принципов формирования изображения в растровой электронной микроскопии.
В процессе исследования образца с большой высотой рельефа становится затруднительной одновременная настройка резкости на верхней и нижней поверхности. Однако в случае существенной дистанции между граничными позициями, в которых изображение начинает размываться, можно говорить о значительной глубине резкости, и наоборот.
 |
| Соотношение между углом апертуры при формировании электронного зонда и глубиной резкости |
Как можно видеть на верхнем рисунке, при малых углах апертуры, когда лучи, формирующие электронный зонд почти параллельны, изображение остается резким в большом диапазоне изменения фокусного расстояния. В то же время значительные углы апертуры, образованные лучами электронного зонда, сопряжены с нарушением резкости даже при малых вариациях фокусного расстояния. Формирование изображения в оптическом микроскопе (ОМ) также тесно связано с величиной апертуры, хотя и не предполагает организацию сканирования электронным зондом. Зависимость глубины резкости от апертуры носит обратный характер, и диапазон качественного изображения возрастает при уменьшении угла. Кроме того, необходимо учитывать возможность появления размытых линий с ростом увеличения, поскольку глубина резкости находится в обратной зависимости от масштаба изображения.
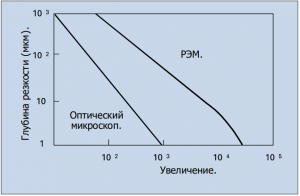 |
| Сравнительная глубина резкости системы РЭМ и оптического микроскопа |
На вышерасположенном рисунке представлены сравнительные графики зависимости глубины резкости от увеличения для электронного и оптического микроскопа (РЭМ и ОМ). В системе РЭМ обеспечивается значительно большая глубина резкости, чем даже в стереоскопическом микроскопе, лучшем по данному параметру в линейке оптических устройств. Причиной является существенно меньший угол апертуры в системе РЭМ, по сравнению с оптическим микроскопом. В любом случае следует учитывать зависимость глубины резкости от условий наблюдения.
На нижнем рисунке в сравнении приводятся изображения поверхности разлома винта, полученные средствами оптической и электронной микроскопии (ОМ и РЭМ). Существенная неровность исследуемого образца приводит к тому, что лишь небольшой участок отображается резко в оптическом микроскопе. При этом в силу значительной глубины резкости системы РЭМ на фото качественно представлена вся поверхность в поле зрения.
| Изображение ОМ | Изображение РЭМ |
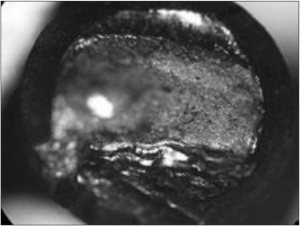 |
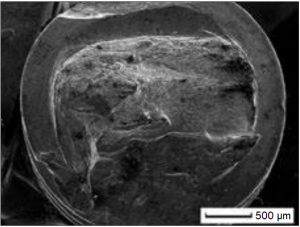 |
| Изображения одного и того же участка поверхности, полученные средствами ОМ и РЭМ | |
Почему мы видим изображения?
Поскольку изображение РЭМ выглядит, как в процессе наблюдения невооруженным глазом, визуально все особенности объекта представляются интуитивно понятными. Однако время от времени возникает труднообъяснимый контраст отдельных элементов, управление которым требует глубокого понимания принципов формирования изображения в растровой электронной микроскопии.
Взаимодействие электронов с образцом
На рисунке расположенном ниже наглядно показано смоделированное по методу Монте-Карло поведение электронов в процессе бомбардировки поверхности, последующего рассеяния в объеме с постепенной потерей энергии и поглощения в материале образца. Диапазон рассеяния варьируется в зависимости от энергии электронов, атомного номера элементов, входящих в состав образца, и плотности вещества. Как можно понять, зона рассеяния возрастает с увеличением энергии электронов и уменьшается при больших значениях атомного номера и плотности.
 |
| Моделирование рассеяния электронов в образце по методу Монте-Карло |
Схема на нижнем рисунке иллюстрирует механизм генерации различных типов излучения под воздействием падающего на поверхность и проникающего в объем образца пучка электронов. В растровой электронной микроскопии подобные сигналы применяются в процессе исследования и анализа поверхности (или прилегающего слоя). Оборудование РЭМ, таким образом, служит не только инструментом исследования морфологии, но и представляет собой универсальное средство проведения элементного анализа и контроля состояния материала.
 |
| Механизм формирования излучения различного типа при бомбардировке образца пучком электронов |
На рисунке ниже приводится распределение энергии излучаемых образцом электронов различного типа. Энергия вторичных электронов ограничена уровнем 50 эВ. В то же время распределение энергии электронов обратного рассеяния простирается от величин, сопоставимых с параметрами падающего пучка, до весьма низких значений порядка 50 эВ. Небольшие пики в энергетической зоне обратного рассеяния соответствуют электронам Оже.
 |
| Распределение энергии электронов, излучаемых с поверхности образца |
Вторичные электроны
При проникновении исходного луча в объем образца и взаимодействии с атомами вещества инициируется излучение вторичных электронов из состава валентных оболочек. Малая энергия предопределяет быстрое поглощение вторичных электронов, генерация которых произошла на значительной глубине. Таким образом, за пределы объема образца выходят только электроны, излучаемые из приповерхностного слоя. Как следствие, кроме чрезвычайной чувствительности данного эффекта к характеру поверхности, просматривается также тенденция к возрастанию уровня эмиссии вторичных электронов с увеличением угла наклона образца, как показано на рисунке.
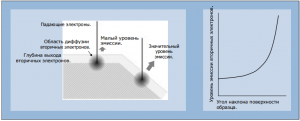 |
| Соотношение между углом падения луча и эмиссией вторичных электронов |
Пример изображения, полученного во вторичных электронах, приводится на нижнем рисунке. Вариация яркости обусловлена разным углом падения электронного луча на грани кристалла. Указанная особенность позволяет применять методику регистрации вторичных электронов в процессах исследования рельефа поверхности. Малой энергией излучаемых электронов обусловлена высокая чувствительность к поверхностному потенциалу образца, приводящая к возникновению аномального контраста в присутствии электрического заряда. Регистрация вторичных электронов в этой связи зачастую применяется в операциях измерения рабочего напряжения элементов интегральной схемы и полупроводниковых приборов.
 |
| Изображение кристалла оксида вольфрама во вторичных электронах |
Отраженные электроны
Электроны обратного рассеяния, отраженные в направлении, противоположном падающему пучку, и излучаемые с поверхности в процессе бомбардировки, обладают более высокой энергией, чем вторичные, а значит несут информацию из глубинных областей образца и характеризуются высокой чувствительностью к составу материала. Как показано на расположенном ниже рисунке , уровень генерации электронов обратного рассеяния возрастает с повышением атомного номера элементов, входящих в состав образца. При этом области, сформированные более тяжелыми атомами, выглядят ярче на изображении в отраженных электронах, что позволяет использовать методику в процессах анализа состава вещества.
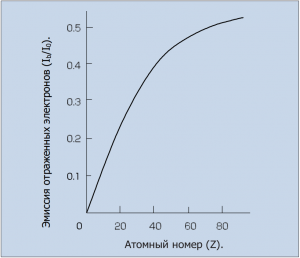 |
| Зависимость интенсивности излучения электронов обратного рассеяния от атомного номера элементов образца |
На рисунке приводится пример изображения, полученного посредством регистрации электронов обратного рассеяния.
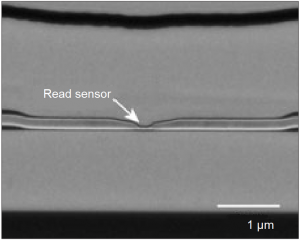 |
| Пример изображения в отраженных электронах.
Образец: магнитная головка жесткого диска |
Кроме того, как можно видеть на размещенном рисунке, в условиях высокой неоднородности поверхности образца интенсивность излучения отраженных электронов значительно выше в направлении зеркального отражения, тем самым обусловлена актуальность данной опции при анализе элементов рельефа.
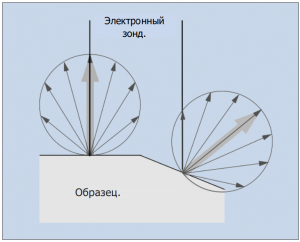 |
| Соотношение между углом падения электронного луча и интенсивностью излучения отраженных электронов |
Как можно видеть на приведенном ниже рисунке, при облучении пучком электронов кристаллического образца с однородной структурой интенсивность обратного рассеяния изменяется в зависимости от ориентации плоскости решетки, от которой происходит отражение.
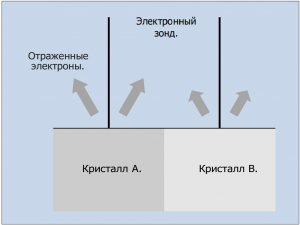 |
| Соотношение между ориентацией кристалла и интенсивностью излучения отраженных электронов |
Использование подобного эффекта позволяет наблюдать изображение, полученное от разных кристаллографических плоскостей с помощью так называемого контраста электронного туннелирования (ECC), показанного в качестве примера на следующем рисунке. Изменение контраста может быть вызвано даже небольшим наклоном кристаллического образца.
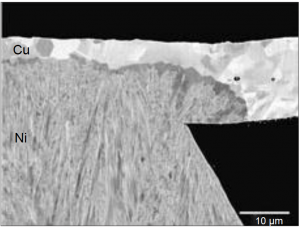 |
| Пример контраста электронного туннелирования (ECC).
Образец: сечение гибкой платы |
Краевой эффект
Как показано на нижеприведенном рисунке, при наличии перепада высоты или тонких выступов на поверхности образца края элементов рельефа отличаются значительной шириной и яркостью (тогда как теоретически должны выглядеть как тонкие линии).
 |
| Пример выраженного краевого эффекта.
Образец: вытравленные углубления на стали. Ускоряющее напряжение: 25 кВ |
Подобное явление носит название краевого эффекта, механизм формирования которого приводится на рисунке ниже. Как можно видеть, даже при воздействии зондом на области, достаточно удаленные от края элемента, последующая диффузия в объем и генерация ответного излучения из валентных зон атомов вещества вызывают эмиссию вторичных электронов с боковых поверхностей рельефа.
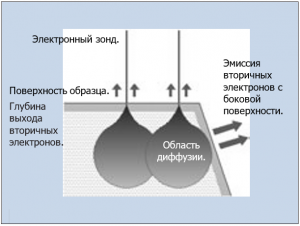 |
| Диффузия падающих на поверхность электронов и результирующий краевой эффект |
Влияние ускоряющего напряжения
Значением ускоряющего напряжения определяется глубина проникновения электронов, падающих на поверхность образца. В то же время чрезмерная величина напряжения приводит к возрастанию фона за счет информации из глубинных слоев материала и понижению контраста формируемого изображения. На нижнем рисунке отчетливо наблюдается эффект расширения электронного зонда внутри образца при высоком ускоряющем напряжении, что вызывает наложение неясного в данном случае изображения присутствующего элемента структуры и регистрируемого излучения с поверхности. Кроме того, увеличивается краевой эффект. Таким образом, четкое изображение поверхностных структур достигается при более низком ускоряющем напряжении. Например, минимальное ускоряющее напряжение в СЭМ KyKy составляет всего 0.2 кВ, в то время как миксимум – 30 кВ.
 |
| Наложение регистрируемой информации о глубинной структуре на изображение рельефа поверхности |
На рисунке расположенном ниже приводятся изображения перекрывающих друг друга тонких пластин кристаллов нитрида бора, полученные при трех различных ускоряющих напряжениях. При величине напряжения порядка 10 кВ сквозь кристаллы, состоящие из элементов с малым атомным номером, видны расположенные ниже. Кроме того, на изображениях отчетливо просматриваются две градации яркости «плавающих» кристаллов, светлая и темная. В первом случае причиной повышения яркости служит регистрация эмиссии вторичных электронов с нижней стороны плавающего кристалла. Более темное изображение соответствует ситуации, в которой излучение вторичных электронов с нижней стороны предотвращается кристаллами, расположенными непосредственно под плавающими. При снижении ускоряющего напряжения до 1 кВ достигается удовлетворительная контрастность изображений, а также просматривается ступенчатая структура поверхности кристаллов.
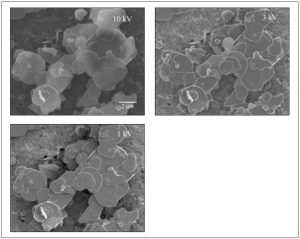 |
| Зависимость контрастности изображений во вторичных электронах от ускоряющего напряжения.
Образец: пластинчатые кристаллы нитрида бора |
Эффект подсветки детектора вторичными электронами
В теории поверхность, перпендикулярная падающему лучу, на изображении во вторичных электронах выглядит темнее и становится ярче при наклоне образца. Фактически на контрастность изображения в системе РЭМ также влияет положение детектора и траектория регистрируемых вторичных электронов, как показано на следующем рисунке.
 |
| Механизм формирования эффекта подсветки вторичными электронами широко распространенного детектора E-T |
Вторичные электроны попадают в детектор под воздействием высокого ускоряющего напряжения, приложенного к его наконечнику. Электроны, излучаемые в противоположном от детектора направлении (с левой стороны зонда), также под влиянием ускоряющего напряжения попадают на регистратор ввиду незначительной собственной энергии. При этом на изображении возникает эффект освещения без теней, вызванный разнообразием траекторий и углов эмиссии регистрируемых вторичных электронов. Кроме того, на детектор попадает определенная часть высокоэнергетичных отраженных электронов, создавая эффект направленного освещения. В результате изображение образца воспринимается как полученное при мягком освещении со стороны детектора, направление которого соответствует траекториям вторичных электронов. В качестве интерпретации эффекта можно предположить освещение образца виртуальным источником, расположенным перед детектором, и наблюдение получаемого изображения со стороны электронного зонда.
Подобный эффект имеет место при оснащении системы РЭМ распространенным детектором E-T . Однако при использовании TTL-детектора принцип облучения несколько меняется.
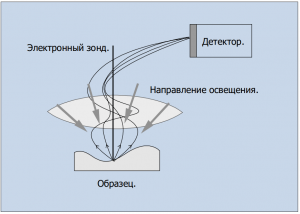 |
| Эффект подсветки детектора TTL |
Как можно видеть на рисунке выше, эмиссия вторичных электронов с поверхности образца переходит в перемещение вдоль оптической оси, ограниченное магнитным полем линзы объектива, после чего они попадают в детектор. В данном случае траектория вторичных электронов соответствует исходному лучу (направлению наблюдения). При этом ослабляется эффект боковой подсветки (уменьшается контрастность изображения рельефа), и изображение РЭМ отличается от полученного детектором E-T.
Засветка детектора отраженными электронами
Эффект освещения поверхности также возникает в случае электронов с обратным рассеянием. Изображение выглядит так, как будто свет падает на образец со стороны детектора. Однако следует учитывать, что при этом осуществляется регистрация электронов, движущихся по прямой, в отличии от вторичных, попадающих в детектор по криволинейной траектории. Этим обусловлена контрастность изображения рельефа поверхности, в значительной степени зависящая от положения детектора отраженных электронов, схематически показанного на нижеприведенном рисунке. Непосредственно над образцом симметрично относительно электронного зонда расположены два детектора (А и В). Информация, позволяющая сформировать изображение рельефа, получается после регистрации отраженных электронов в результате вычитания сигнала В из А, при этом образец выглядит, как будто свет падает со стороны детектора А. В то же время сложение сигналов A и B приводит к исчезновению информации рельефе, но позволяет анализировать изменения структуры и состава образца, поскольку изображение соответствует освещению поверхности в направлении исходного луча.
 |
| Двухзонный детектор электронов обратного рассеяния |
Повышение разрешения изображения
Разрешающая способность
Возможность формирования резкого изображения при точной фокусировке электронного зонда зависит от разрешающей способности системы, соответствующей «минимальному расстоянию, на котором две разные точки отображаются раздельно». Традиционно в растровой электронной микроскопии разрешающая способность оборудования определяется измерением минимального различимого расстояния между двумя объектами.
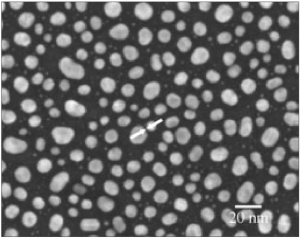 |
| Частицы золота, осажденные на углеродной пластине.
Двумя стрелками показано расстояние между двумя точками порядка 1 нм (разрешение 1 нм). |
На вышестоящем рисунке приводится изображение частиц золота, осажденных на углеродной пластине. Как можно видеть, стрелками обозначено расстояние между двумя наиболее близко расположенными частицами, измерение которого подтверждает достижение разрешающей способности порядка 1 нм. Для сравнения первый РЭМ достигал разрешения порядка 50 нанометров, а самое высокое полученное на сегодня составляет 0,4 нм. Например, в электронных микроскопах KyKy EM6900 LV и EM6900 разрешение достигает 3 нм, а в EM8000 и в EM8100 – 1.5 нм и 1нм соответственно. В целях оптимизации процесса измерений немаловажно подготовить стабильный образец материала, на котором максимально упрощается проведение операций РЭМ. Эталонные образцы для контроля разрешающей способности, а также условия и методика измерений могут отличаться у разных производителей электронных микроскопов, но в любом случае параметр определяется в оптимальных условиях работы оборудования.
Термин «разрешение» во многом аналогичен разрешающей способности, также определяется как «минимальное различимое расстояние между двумя точками на изображении (РЭМ)» и зависит от целого ряда факторов, включая состояние оборудования, состав образца, применяемое увеличение и т.д.
Однако на практике определения «разрешение» и «разрешающая способность» зачастую взаимозаменяемы.
Методы повышения разрешения
Разрешение системы РЭМ во многом определяется диаметром электронного зонда. В принципе, пучок электронов, излучаемый электронной пушкой, фокусируется линзами конденсора и объектива. Но в практических операциях РЭМ возбуждение линзы объектива остается неизменным, а диаметр электронного луча корректируется полем конденсора.
 |
| Изменение диаметра электронного зонда в зависимости от возбуждения линзы конденсатора |
На этом рисунке показана зависимость диаметра электронного зонда от возбуждения (оптической силы) линзы конденсора. По мере возрастания оптической силы конденсора размерр изображения источника электронов (электронного зонда) уменьшается до некоего теоретического значения, определяемого линзой объектива. С уменьшением диаметра электронного луча снижается ток зонда, воздействующего на образец. В случае применения термоэлектронной пушки (TE) и значительном возбуждении линзы конденсора качество изображения (отношение сигнал/шум) быстро ухудшается, а до того, как диаметр электронного луча достигает теоретического предела, регистрируемый сигнал пропадает вовсе из-за отсутствия тока зонда.
Прожектор на основе полевой эмиссии (FE) обеспечивает больший ток зонда, чем термоэлектронные пушки (TE), а кривая на данном рисунке при этом смещается влево. В результате достигается теоретический предел диаметра электронного зонда в процессе наблюдения изображения. Кроме того, при повышении возбуждения объектива кривая смещается вниз, что позволяет получить гораздо более высокое разрешение
Таким образом, сочетанием прожектора на основе полевой эмиссии (FE) и высокоэффективного объектива обеспечивается чрезвычайно высокое разрешение.





.png)