Регистрация электронов валентной зоны, эмитируемых в результате УФ-облучения поверхности образца, осуществляется методами фотоэлектронной спектроскопии с угловым разрешением (ARPES1). При этом открывается возможность исследования электронной структуры твердого тела с применением технологий прецизионного анализа энергетического и углового распределения фотоэлектронов.
1«ARPES» (Angle-Resolved Photoelectron Spectroscopy) – фотоэлектронная спектроскопия с угловым разрешением
 |
Фотоэлектронная спектроскопия (PES2) относится к самым мощным и широко применяемым методам анализа в материаловедении, физике и химии твердого тела. Особая чувствительность методики к типу материала и популярность современных технологий неразрушающего контроля химического состава (XPS3 или ESCA4) и электронной структуры (UPS5 и ARPES) материалов обусловлены характерными особенностями фотоэлектрического эффекта.
2«PES» (Photoelectron Spectroscopy) – фотоэлектронная спектроскопия.
3«XPS» (X-ray Photoelectron Spectroscopy) – рентгеновская фотоэлектронная спектроскопия (РФЭС).
4«ESCA» (Electron Spectroscopy for Chemical Analysis) – электронная спектроскопия для химического анализа.
5«UPS» (Ultraviolet Photoelectron Spectroscopy) – ультрафиолетовая фотоэлектронная спектроскопия (УФЭС).
В процессе освещения поверхности образца определенная энергия фотонов (hv) затрачивается на преодоление сил связи (Eb) и работы выхода (Φ) электронов в твердом теле. Оставшаяся часть преобразуется в кинетическую энергию (Ekin) фотоэлектронов. Подобный переход осуществляется из занятых электронных состояний с энергией Ei на свободные уровни Ef в соответствии с законом сохранения энергии.
Ekin=hv–Eb-∅
В операциях, проводимых по методике UPS и ARPES, анализируемая область ограничивается верхними энергетическими состояниями электронов вблизи уровня Ферми. Особый интерес в современном материаловедении представляют соответствующие энергетические уровни, образующие зоны валентности и проводимости, а также поверхностные состояния в металлах и полупроводниках. Так, принципами сохранения энергии и волнового вектора k (kx, ky, kz) в процессе фотоэмиссии обусловлены характерные углы излучения электронов относительно поверхности, в зависимости от действующего импульса в объеме материала. В результате достигается возможность регистрации интенсивности фотоэмиссии (I) как функции кинетической энергии (Ekin), несущей информацию о химическом составе/силовых параметрах, и угла излучения, соответствующего импульсу (k).
 |
Искажения геометрии поверхности не оказывают влияния на процессы сохранения энергии, также неизменной остается параллельная волновая составляющая импульса kӀӀ (соответствующая значениям kx и ky), тогда как нормальный компонент параметра (k┴) после пересечения поверхности подвержен значительным колебаниям. В модуле анализатора осуществляется регистрация кинетической энергии электронов Ekin (пересчитанной на энергию связи Eb) и угла излучения Θ (параллельной составляющей волнового вектора kӀӀ). Полученные данные далее служат основой формирования двумерного распределения электронов для измеренных значений Ekin и kӀӀ, непосредственно отражающего электронную (зонную) структуру материала.
 |
Контроль угла излучения по второй координате в современных устройствах и системах анализа поверхности достигается посредством наклона образца по оси y или с помощью интегрированного в электронную линзу отражателя, формирующего диаграмму распределения. Построение двумерной карты зоны в координатах kx и ky осуществляется изменением угла излучения по второй оси. Управление направленным вне плоскости импульсом kz становится возможным при вариации энергии фотонов источника возбуждения.
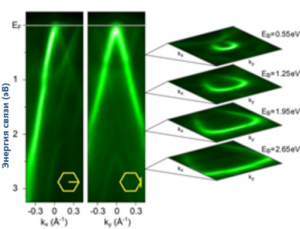 |
Достижение оптимальных результатов в лабораторных условиях требует применения стабильных точечных источников ультрафиолетового излучения высокой интенсивности, играющих ключевую роль в достижении высокой скорости и эффективности процесса измерений, тогда как благодаря малому размеру пятна обеспечивается максимальное угловое (импульсное) разрешение. Компанией SPECS представлен модельный ряд специализированных источников ультрафиолета, от универсальных и надежных устройств для коммерческого применения до высокотехнологичных систем, работающих с различными газами в широком диапазоне энергии фотонов и оснащаемых монохроматорами, позволяющими дополнительно повысить эффективность и разрешение оборудования.
Помимо величин энергии и импульса особый интерес в процессах научного анализа могут представлять и такие параметры, как спин электрона и даже привязка к поверхности в операциях анализа малых областей (импульсная микроскопия). Применение блока регистрации с избирательной чувствительностью позволяет измерить интенсивность эмиссии электронов с положительным и отрицательным значением спина («спин-вверх» и «спин-вниз»), рассчитать разность и так называемую функцию асимметрии.
 |
Необходимо учитывать, что источником электронов, регистрируемых методами ARPES (и иных, основанных на механизме фотоэмиссии) является возбужденное состояние атомов вещества. Однако достаточно хорошей аппроксимацией зачастую является предположение о схожести конечного и основного состояния, позволяющее делать выводы об электронной структуре твердого тела.
Демонстрация возможностей сканирующего объектива ASTRAIOS 190 с одинарным лучом. На примере графена/SiC, возбуждаемого монохромным источником фотонов с энергией He II (41,2 эВ) и малым размером УФ-пятна можно в динамике наблюдать эффект применения отклоняющей системы.
На нашем сайте вы можете ознакомиться с доступными к заказу РФЭС решениями (XPS, NAP XPS и другое): оборудование рентгеновской фотоэлектронной спектрометрии.