Спектроскопия обратного рассеяния медленных ионов — СОРМИ ((LE)ISS, Low Energy Ion Scattering Spectroscopy) — обеспечивает максимальную чувствительность к составу верхнего атомного слоя за счёт регистрации энергетического спектра ионов, упруго рассеянных под углом ~180° при энергиях первичного пучка E0 = 0,3–5 кэВ.
 |
Высокая поверхностная селективность метода обусловлена большим сечением упругого рассеяния ионов на атомах мишени при низких энергиях: средняя длина свободного пробега ионов с E0 ≈ 1 кэВ в твёрдом теле составляет ~0,3–0,5 нм, что ограничивает область взаимодействия преимущественно первым атомным слоем. В отличие от методов, основанных на электронной или фотонной эмиссии, в LEISS вклад от подповерхностных атомов экспоненциально подавлен.
Энергия иона, рассеянного под углом θ в бинарном столкновении, определяется кинематическим фактором K:
E = K · E0 , K = [M1 cos θ + √(M2 ² − M1 ² sin ² θ)] ² / (M1 + M2) ²
где M1 — масса иона-зонда (He+, Ne+, Ar+), M2 — масса атома мишени. Зависимость K(M2) позволяет проводить элементную идентификацию с разрешением по массе ΔM/M ≈ 1–5% (в зависимости от E0 , θ и энергетического разрешения анализатора).
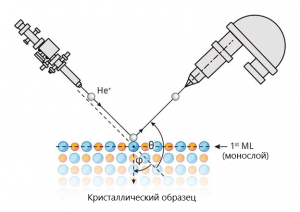 |
Регистрация спектра рассеянных ионов осуществляется полусферическим энергоанализатором с разрешением ΔE/E ≈ 0,3–1%. Для минимизации радиационных повреждений и распыления поверхности применяются:
- низкие токи пучка (< 10 нА/см²);
- сканирование пучка по площади образца;
- криогенное охлаждение образца при необходимости;
- использование инертных ионов-зондов (He+, Ne+) с минимальным сечением внедрения.
Количественный анализ состава поверхности в LEИС требует учёта:
- сечения упругого рассеяния σ(E0 , θ , M1 , M2 ), рассчитываемого в приближении экранированного кулоновского потенциала (например, потенциал Циглера–Бирсака–Литтмарка);
- вероятности нейтрализации иона P0 (M2 , кристаллографическая ориентация), зависящей от локальной электронной плотности и работы выхода;
- геометрического фактора детектирования и эффективности регистрации.
Для относительных измерений при сопоставимых массах элементов калибровка может выполняться по референсным образцам с известным составом.
Области применения LEISS:
- Исследование сегрегации: мониторинг обогащения поверхности легирующими элементами в сплавах;
- Тонкие плёнки и многослойные структуры: контроль состава первого монослоя, диффузионных барьеров;
- Катализ: анализ активного центра на поверхности катализаторов в модельных условиях;
- Двумерные материалы: верификация стехиометрии и чистоты поверхности графена, дихалькогенидов;
- Кристаллография поверхности: использование эффекта теней и фокусировки (blocking/channeiling) для определения позиций атомов в поверхностном слое.
Интеграция LEISS в существующие многометодные комплексы (РФЭС, Оже-спектроскопия, ДЭС) упрощается за счёт совместимости с полусферическими анализаторами и источниками ионов низкой энергии, уже применяемыми для компенсации заряда. Модернизация сводится к установке специализированного ионного источника с коллимацией пучка и синхронизации систем регистрации.
Технические спецификации систем для LEISS, включая источники ионов, энергоанализаторы и конфигурации для совмещённых измерений, представлены в каталоге оборудования для электронной и ионной спектроскопии.
*«(LE)ISS» (Low Energy Ion Scattering Spectroscopy) — спектроскопия обратного рассеяния медленных ионов. В литературе также встречаются обозначения: ISS, LEIS, TOF-LEIS (при использовании время-пролётной детекции). СОРМИ — принятый русскоязычный эквивалент.





.png)