Механизм образования заряда
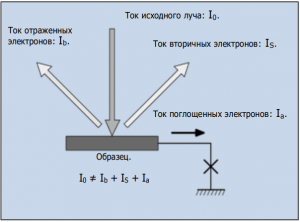 |
| Потоки электронов в случае непроводящего образца |
Проникающие в образец электроны теряют свою энергию и далее поглощаются в объеме материала. В случае проводящего образца через него генерируется электрический ток, однако движение электронов останавливается в диэлектрике с формированием и накоплением заряда, схематически показанного на рисунке выше. Как можно заметить, количество падающих и покидающих образец электронов не совпадает. В общем случае исходный поток больше, и образец заряжается отрицательно. Продолжительное облучение электронным пучком способствует формированию отрицательного локального заряда в определенной области. Дальнейшее увеличение потенциала приводит к возникновению разряда и возврату к исходному состоянию поверхности. Если же по какой-либо причине количество выходящих из образца электронов превышает число поступающих, формируется положительный заряд.
Влияние заряда на контрастность изображения
В процессе сканирования электронным зондом заряженной поверхности образца происходит отталкивание и сдвиг луча под действием потенциала, что приводит к искажению изображения. Кроме того, при возникновении разряда электронный зонд на мгновение возвращается в исходную позицию. В результате изображение РЭМ выглядит разорванным, как показано на рисунке ниже.
 |
| Искажение изображения РЭМ, вызванное зарядом образца |
Что же происходит в случае невысокого уровня заряда поверхности и в отсутствии видимого воздействия на характер перемещения электронного зонда? В подобных условиях остается влияние локального заряда на траекторию и эффективность регистрации вторичных электронов с малой энергией, в результате соответствующая область изображения выглядит светлой или тёмной. Существенная разница в количестве зарегистрированных электронов лежит в основе формирования так называемого потенциального контраста. Так, отрицательный потенциал на поверхности приводит к увеличению напряжения между детектором и образцом, следовательно в датчик поступает большее количество вторичных электронов, а область локального заряда становится ярче на изображении (возрастает эффективность регистрации). Наоборот, положительный заряд образца снижает эффективность работы регистратора и количество обнаруживаемых электронов, что приводит к уменьшению яркости данной области до темных тонов на изображении. Причина состоит в значительной напряженности электрического поля, генерируемого в области локального заряда, превышающего сформированное детектором и вызывающего отклонение траектории излучаемых с поверхности вторичных электронов, которые более не попадают на регистратор.
На располагающемся ниже рисунке показано явление, связанное с потемнением соответствующей локальной области.
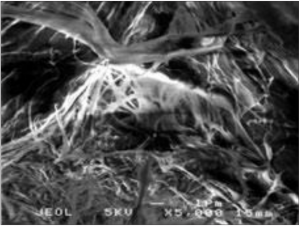 |
| Аномальный контраст заряженной поверхности |
Меры профилактики заряда поверхности
Формирование проводящего покрытия
Наиболее распространенной технологией предотвращения накопления заряда является нанесение на поверхность диэлектрического образца покрытия с высокой проводимостью, например тонкой металлической пленки, методами ионного напыления и осаждения в вакууме. Как правило, в качестве материала покрытия толщиной до 10 нм применяются благородные металлы (Au, Pt, Au-Pd, Pt-Pd), тем самым обеспечивается высокий уровень стабильности и выхода вторичных электронов, а точность воспроизведения морфологии поверхности – формированием тонкого слоя. Однако на развитом рельефе при этом возможна потеря непрерывности покрытия и возникновение области локального заряда.
Операции при низком ускоряющем напряжении
В случае накопления заряда на поверхности возникает различие в количестве электронов, проникающих в материал и покидающих образец. Как показано на рисунке ниже, с уменьшением ускоряющего напряжения исходного луча возрастает выход вторичных электронов и при достижении значения порядка 1 кВ превышает количество падающих. Однако само существование точки баланса между падающим и исходящим потоком электронов при столь низком ускоряющем напряжении эквивалентно отсутствию заряда поверхности и означает возможность формирования качественного изображения РЭМ диэлектрического образца.
 |
| Относительное количество излучаемых вторичных электронов в зависимости от ускоряющего напряжения |
На представленном ниже рисунке приводятся примеры снимков керамического материала без покрытия. При ускоряющем напряжении 10 кВ информация о рельефе поверхности представлена скудно, однако отчетливо просматриваются аномальные размытые области. В то же время при значении ускоряющего напряжения 1 кВ формируется качественное изображение с подробными деталями без образования размытых зон.
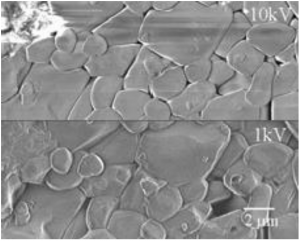 |
| Изображения во вторичных электронах керамического образца (без покрытия) при различном ускоряющем напряжении |
Исследование наклонной поверхности
Как упоминалось ранее, количество излучаемых вторичных электронов увеличивается при наклоне поверхности образца относительно исходного луча, что также позволяет выполнять исследование непроводящих материалов без образования заряженных областей. Методика эффективна для проведения операций на образцах с небольшим рельефом поверхности.
Режим низкого вакуума в растровой электронной микроскопия
Далее будет подробно рассматриваться механизм функционирования системы РЭМ в режиме низкого вакуума (LVSEM), позволяющем проводить исследование непроводящего образца в отсутствии искажений, вносимых поверхностным зарядом. Из линейки микроскопов KyKy, например, этот режим имеется в модели EM6900 LV. При снижении вакуума в рабочей камере возрастает остаточное количество молекул газа, ионизируемых в потоке электронов и достигающих поверхности уже в качестве положительных частиц, что приводит к нейтрализации заряда образца.
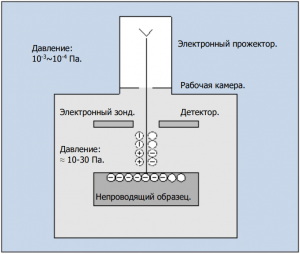 |
| Организация процесса исследования непроводящего образца в условиях низкого вакуума |
Необходимое количество положительных ионов, при котором обеспечивается нейтрализации заряда, достигается установкой в рабочем объеме давления 10-100 Па (величина варьируется в зависимости от материала). На рисунках ниже приводятся изображения раковины фораминиферы, полученные без нанесения дополнительного проводящего покрытия при разном разрежении в рабочей камере, в том числе в режиме низкого вакуума (LVSEM). Аномальный контраст, обусловленный зарядом поверхности, возникает в условиях высокого вакуума, но исчезает при возрастании давления. Необходимо отметить отчетливый эффект образования теней от элементов рельефа на последнем изображении, полученном в отраженных электронах.
| Режим высокого разрежения | Режим низкого вакуума |
 |
 |
| Примеры изображения непроводящего образца, сформированного в высоком вакууме, а также в системе LVSEM.
Образец: раковина фораминиферы (без покрытия) |
|
Основы методики подготовки образца
Перед загрузкой в систему РЭМ требуется обеспечить соответствие образца следующим требованиям:
а) поверхность, подлежащая исследованию полностью открыта.
б) образец надежно зафиксирован на предметном столике.
в) достаточный уровень электропроводности образца.
Усиление контраста и подготовка поверхности для исследования
После обрезки материала до технологических размеров необходимо вскрытие соответствующего слоя для последующего проведения операций РЭМ, если только не выполняется исследование собственной поверхности образца. В любом случае может потребоваться удаление пленок, препятствующих формированию изображения.
Исследование внутренней структуры проводится после подготовки сечения образца следующими методами.
Формирование скола
Поперечное сечение фрагмента твердого материала может быть получено посредством раскалывания образца. В случае если требуется исследование полупроводниковой структуры, сформированной на монокристаллической подложке Si или GaAs, используется свойство преимущественного расщепления материала по плоскостям в определенном направлении с образованием требуемого сечения. В иных методиках достижение необходимой твердости образца, мягкого при нормальной температуре, достигается в процессе охлаждения в жидком азоте.
Разрез
Подготовка мягкого образца, например из полимерных материалов, может осуществляться посредством реза ультрамикротомом, изначально применяемым в процессе формирования тонких пластин для операций просвечивающей электронной микроскопии (TEM) Методика позволяет достигать высокой плоскостности поперечного сечения. В операциях РЭМ с низким увеличением допускается наличие отдельных рубцов на срезе материала, который при этом может производиться лезвием бритвы.
Механическая полировка
Оптимальной методикой подготовки образцов из разнообразных металлических или минеральных материалов зачастую является механическая полировка после фиксации соответствующего фрагмента в слое твердеющего полимера, в процессе которой постепенно снижается размер зерен применяемого абразива. На завершающем этапе достигается состояние зеркальной поверхности.
Ионно-лучевое травление
В последнее время расширяется применение технологий ионно-лучевого фрезерования. Так, например, система формирования сфокусированного ионного пучка (FIB) позволяет получать сечение образца с точностью позиционирования в несколько сотен нанометров. Кроме того, получает распространение методика с использованием широкого пучка ионов Ar, обеспечивающая гораздо большую площадь сечения, но при несколько пониженной точности, по сравнению с технологией FIB.
Повышение контрастности
В ряде случаев не обеспечивается контрастность изображения во вторичных электронах достаточно гладкой поверхности сечения образца. В качестве основной методики повышения контрастности в первую очередь применяется селективное химическое или физическое травление с формированием рельефа поверхности и возможностью исследования внутренней структуры с помощью вторичных электронов. Вторая технология носит название «окрашивания» в результате обработки тяжелыми металлами, такими как Os и Ru, специфических областей высокомолекулярного полимера и последующее исследование композиционного изображения (COMPO) в отраженных электронах. Кроме того, при значительной вариации состава или кристаллической структуры композиционное изображение или эффект контраста электронного туннелирования (ECC) наблюдается в электронах обратного рассеяния даже без предварительной обработки образца (усиления контрастности).
Фиксация образца
Необходимо обеспечить электрический контакт и надежную фиксацию образца на предметном столике.
Объемные образцы
Объемный образец крепится к держателю проводящей двусторонней клейкой лентой или пастой, а при достаточной однородности формы применяется штатный зажим. Диэлектрический объемный образец максимально покрывается проводящей пастой, за исключением области, подлежащей исследованию.
Сыпучие материалы и порошки
Подобные образцы наносятся распылением на значительную по возможности область двусторонней клейкой ленты или проводящей пасты. В то же время допускается и суспензионный способ подготовки соответствующих образцов, при котором осуществляется взвесь материала в дисперсионной среде (органическом растворителе, воде и т.д.), нанесение каплями на алюминиевую фольгу или пластину кремния (S) с последующей сушкой.
Покрытие
На диэлектрической поверхности, как правило, требуется формирование проводящего покрытия в виде тонкой металлической пленки методами ионного напыления или осаждения в вакууме.
Технология ионного напыления, в свою очередь, подразделяется на две методики. К первой относится широко распространенная система нанесения покрытия ионным распылением металлической мишени в диодном реакторе, во второй используется принцип ионно-лучевого формирования пленки. На рисунке ниже показана схема функционирования устройства для формирования покрытия методом ионного распыления. После бомбардировки мишени положительными ионами, образуемыми в рабочем объеме при разряде в условиях низкого вакуума порядка 10 Па, распыляемые частицы металла в результате интенсивного столкновения с остаточными молекулами газа осаждаются на поверхность образца с разных направлений, обеспечивая тем самым однородность формируемого слоя. С другой стороны, в установках ионно-лучевого напыления качество тонкой пленки обеспечивается в условиях высокого вакуума, в котором располагается мишень и образец.
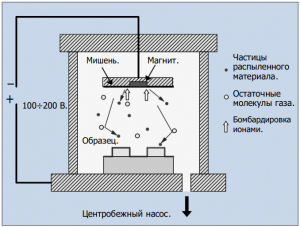 |
| Конструкция установки ионного напыления |
В процессе вакуумного осаждения исходный материал нагревается, испаряется и наносится в виде тонкой металлической пленки на поверхность образца. Высоким вакуумом уровня 10-3 Па в рабочем объеме испарителя обусловлено незначительное остаточное количество молекул газа и, как следствие, слабое рассеяние частиц материала и невозможность осаждения на поверхность со всех направлений. В этом случае формирование однородной пленки достигается наклоном и вращением образца.
Предпочтительное применение благородных металлов (Au, Au-Pd, Pt, Pt-Pd и т.д.) обусловлено стабильностью формируемого покрытия и высоким выходом вторичных электронов. В операциях с большим увеличением, как правило, используется Au-Pd, Pt или Pt-Pd. В отдельных случаях, включая элементный анализ, допускается применение С или Al. Необходимо учитывать особенности каждого материала, так, Pt и Pt-Pd сложно сочетается с системами вакуумного осаждения, а С и Al трудно поддаются распылению.
Покрытием большой толщины скрадываются мелкие элементы рельефа, тогда как потеря непрерывности чрезмерно тонкой пленки служит причиной локального образования поверхностного заряда. Оптимальная толщина покрытия находится в диапазоне 2~10 нм.
Обработка биоматериалов
Образцы с высоким содержанием воды, включая биологические ткани, подвержены деформации при помещении в рабочую камеру РЭМ без предварительной обработки. Негативный эффект предотвращается проведением следующих процедур и исследованием поверхности образца с сформированным покрытием. Аналогичным операциям подвергаются и образцы пищевых продуктов.
Резка образца и очистка ткани
В процессе подготовки образца осуществляется обрезка ткани до требуемого размера, обеспечивается хранение перед операцией сушки и надлежащий уход во избежание деформации. Кроме того, может потребоваться очистка поверхности.
Фиксация
Изменение структуры отделенных фрагментов ткани после гибели организма предотвращается методами химической фиксации с применением глутаральдегида, формальдегида и тетроксида осмия. Так, адсорбция значительного количества металлического осмия в подобном процессе приводит к повышению электропроводности (проводящее окрашивание). Для иных образцов более применимой для подавления структурных изменений оказывается технология быстрого замораживания (физическая фиксация).
Дегидратация
Деформации образца также предотвращается методами обезвоживания посредством погружения на определенное время в раствор этанола или ацетона, концентрация которого при этом поэтапно изменяется.
Сушка
После удаления этанола или ацетона требуется дополнительная сушка фрагмента ткани, в процессе которой возможна деформация образца силами поверхностного натяжения, если операция проводится в естественных условиях. Минимизация подобного эффекта достигается применением специальных методик обработки, например, сушки в критической точке или сублимации.
Крепление образца и формирование покрытия
Процесс проводится по аналогии с процедурами, принятыми для непроводящего образца.
Операции РЭМ в условиях низкого вакуума
Стандартные операции растровой электронной микроскопии осуществляются при давлении в рабочем объеме 10-3÷10-4 Па, тогда как в системах, функционирующих в условиях низкого вакуума (LVSEM), значение поднимается до уровня 10÷100 Па. Высокое разрежение в отсеке электронного прожектора поддерживается благодаря установке диафрагмы между электронно-оптической колонной и камерой образца, а также независимой работе узлов дифференцированной вакуумной системы. Применение детектора E-T в оборудовании LVSEM представляется затруднительным, поскольку подача напряжения на сцинтиллятор и остаточное давление газа инициирует возникновение разряда, тем самым обусловлена необходимость использования устройства регистрации электронов обратного рассеяния, позволяющего повысить композиционный контраст и обеспечить формирование изображения РЭМ с устойчивым эффектом затенения элементов рельефа. Кроме того, в отдельных случаях актуально применение методики регистрации ионного тока с увеличением выхода вторичных электронов в низком вакууме за счет нейтрализации заряда поверхности.
Как упоминалось ранее, в условиях низкого вакуума (LVSEM) возможно исследование непроводящих образцов без нанесения дополнительного покрытия. Кроме того, благодаря допустимости повышения давления в рабочей камере подобных систем обеспечивается проведение операций с материалами, отличающимися значительным выделением газов, нестабильными в высоком вакууме и влагосодержащими, после охлаждения в жидком азоте.
Понижение давления в стандартной системе РЭМ до рабочих значений высокого вакуума и возможности проведения операций с пористым образцом, выделяющим большое количество газа, требует значительных затрат времени. В противоположность этому, процессы с подобным материалом в условиях низкого вакуума (LVSEM) могут проводиться уже при оперативно достигаемом значении давления в рабочей камере 10~100 Па.
На рисунке ниже в качестве примера приводится изображение (LVSEM) фрагмента бетона, выделяющего значительное количество паров. Время получения изображения РЭМ составляет несколько минут.
 |
| Изображение бетонного образца в режиме низкого вакуума (LVSEM) |
Сохранение исходного состояния образца с высоким содержанием влаги обеспечивается быстрым охлаждением в жидком азоте, при этом последующие операции проводятся с материалом в замороженном состоянии. Остаточное давление в рабочей камере (LVSEM) препятствует испарению льда даже при относительно высокой температуре, например, -20 °C и значении 100 Па, соответствующем низкому вакууму. Подобные условия достигается с помощью элемента Пельтье, при этом исключается необходимость в применении жидкого азота. Кроме того, в режиме низкого вакуума (LVSEM) упрощается формирование изображения замороженного при атмосферном давлении образца, загруженного далее в систему РЭМ и исследуемого в процессе повышения температуры (непосредственной сублимации), как показано на нижнем рисунке.
 |
| Изображение РЭМ в условиях низкого вакуума (LVSEM), полученное после сублимационной сушки. Образец: лактобактерии |

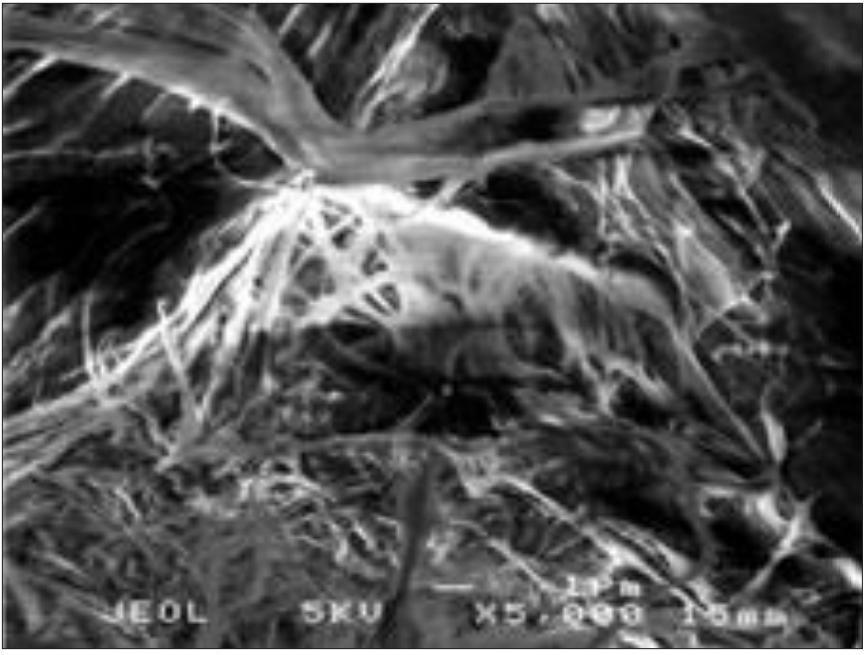



.png)