Система электронно-лучевой литографии EBL-100FS

Китай
Ускоряющее напряжение до 100кВ
Описание Система электронно-лучевой литографии EBL-100FS
Система электронно-лучевой литографии EBL-100FS – это высокопроизводительное решение для нанолитографии, предназначенное для формирования структур субмикронного и нанометрового диапазона. Оборудование ориентировано на научно-исследовательские лаборатории, центры коллективного пользования и опытные производства в областях полупроводниковой электроники, фотоники и MEMS-технологий. Система напрямую записывает структуры на резисте с высокой точностью совмещения. Она предназначена для разработки новых топологических норм, изготовления масок и прототипирования устройств с минимальной шириной линии до 10 нм.
Принцип работы и конструкция
Работа системы EBL-100FS базируется на использовании электронной оптики с ускоряющим напряжением до 100 кВ. Источником электронов служит катод Шоттки с автоэмиссией, обеспечивающий высокую яркость и стабильность пучка. Формирование изображения осуществляется методом векторного сканирования, что оптимизирует время экспонирования по сравнению с растровым методом. Перемещение образца реализовано по схеме Step & Repeat на вакуумном столе с ортогональной структурой. Позиционирование контролируется лазерной интерферометрической системой с дифференциальной измерительной структурой, обеспечивающей разрешение измерения лучше 0.6 нм и стабильность длины волны лазера в вакууме на уровне ±0.2 ppm в течение всего срока службы. Вакуумная система комбинированного типа включает сухие форвакуумные насосы, турбомолекулярные насосы производительностью от 240 л/с и ионные насосы, что гарантирует чистоту колонны и рабочей камеры.
Ключевые особенности и преимущества
- Нанометровое разрешение: ускоряющее напряжение до 100 кВ обеспечивает размер пятна пучка ≤2.9 нм и минимальную ширину линии ≤10 нм.
- Высокая стабильность пучка: дрейф положения не превышает 10 нм/ч, нестабильность тока составляет не более ±0.5%/ч.
- Прецизионное позиционирование: точность сшивки полей и совмещения слоев ≤±10 нм благодаря лазерной интерферометрической системе с разрешением лучше 0.6 нм.
- Производительность: метод векторного сканирования со скоростью 100 МГц сокращает время экспонирования по сравнению с растровыми системами.
- Автоматизация процессов: встроенная коррекция близостных эффектов (PEC), поддержка формата GDSII и система автоматической калибровки искажений поля.
- Гибкость конфигурации: поддержка пластин диаметром 6 дюймов (опционально 8 дюймов) и масок типов 6025/4525, возможность установки автоматического загрузчика на 10 кассет.
- Надежность и безопасность: соответствие стандартам SEMI-S2 и SEMI F47, опциональная активная виброизоляция с эффективностью гашения >90% на частоте 10 Гц.

|
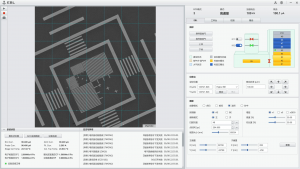 |
|
Внешний вид ПО EBL-100FS |
Примеры применения
 |
 |
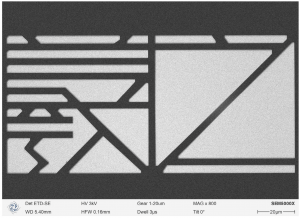 |
 |
 |
 |
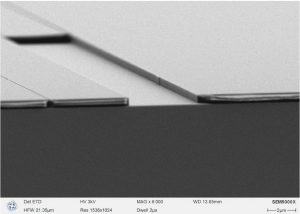 |
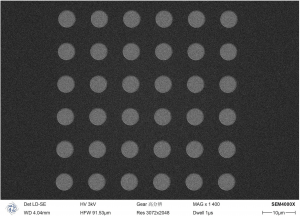 |
|
Параметр
|
Значение
|
|---|---|
|
Тип источника электронов
|
Катод Шоттки с автоэмиссией (Thermal Field Emission)
|
|
Ускоряющее напряжение
|
2–100 кВ (рабочее до 100 кВ)
|
|
Ток пучка (на образце)
|
50 пА – 100 нА
|
|
Минимальный размер пятна пучка
|
≤2.9 нм
|
|
Минимальная ширина линии
|
≤10 нм
|
|
Режим сканирования
|
Векторное сканирование
|
|
Скорость сканирования
|
100 МГц
|
|
Максимальное поле экспонирования
|
1000 × 1000 мкм
|
|
Точность сшивки полей (Stitching)
|
≤±10 нм
|
|
Точность совмещения (Overlay)
|
≤±10 нм
|
|
Стабильность положения пучка
|
≤10 нм/ч
|
|
Стабильность тока пучка
|
≤±0.5%/ч
|
|
Перемещение стола (Step & Repeat)
|
190 × 170 мм
|
|
Разрешение системы позиционирования
|
≤0.6 нм (лазерный интерферометр)
|
|
Типы обрабатываемых образцов
|
Пластины до 6 дюймов (опционально 8″), маски 6025/4525
|
|
Вакуумная система
|
Комбинированная (сухие форвакуумные, турбомолекулярные, ионные насосы)
|
|
Коррекция близостных эффектов (PEC)
|
Есть (программная компенсация дозы экспонирования)
|
|
Автоматическая калибровка
|
Коррекция искажений поля, фокусировка по высоте (опционально)
|
Может быть полезно:
Наноимпринтный литограф NIL-150/200

В процессе уменьшения размера элементов, наряду с традиционной литографией, […]
Запрос цены ПодробнееПлатформа PicoVAC mini

Малогабаритная настольная установка магнетронного напыления PicoVAC mini предназначена […]
Запрос цены Подробнее


